热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A
从2000年夏普推出全球首款搭载后置11万像素摄像头的拍照手机J-SH04开始,用户对智能手机摄像性能要求不断提高,各厂商技术不断 更新迭代,手机摄像头逐渐向多摄、CIS 高像素、7P/8P、镜片玻塑混合、潜望式镜头变焦、ToF 等多方向发展。

根据研究机构MarketsandMarkets最新发布的研究报告显示,2020年全球摄像头模块市场规模为315亿美元,到2024年,该市场将增长至446亿美元。预测期内(2019-2024年)的年复合增长率为7.2%。报告指出,全球摄像头模块市场的增长主要取决于以下几个因素:一是多摄像头的智能手机的快速发展;二是公共安全和安保问题频发促进了监控摄像头的采用;三是摄像头模块组件在设备集成方面的技术进步;四是智能手机中Tof相机的需求上升。
从镜头成像原理来说,手机摄像头是通过镜头捕捉画面并在图像传感器上产生可移动电荷, 然后经由图像传感器将电信号转化为数字信号、DSP 对数字信号处理后,在屏幕上呈现图 像。因此,除镜头捕捉画面能力强弱外,图像传感器也是影响摄像成像效果的关键因素。
根据前瞻产业研究院估算,2018年单颗摄像头成本构成中,约52%来自于图像传感器、 20%来自于镜头、19%来自于模组封装,仅6%和3%来自于音圈马达和红外滤光片。目前,图像传感器可分为CCD(电荷耦合器件)传感器和 CMOS(互补金属氧化物半导体) 传感器(CIS)两大类。CCD图像传感器是一种用于捕捉图像的感光半导体芯片,其所捕捉到的画面中每个像素的电荷数据会依次传送到下一个像素中,由最底端输出后经传感器边缘放大后输出。CIS是将图像信息经光电转换后产生电流或电压信号,在CMOS晶体管开关阵列中直接读取,无需逐行读取,因此在灵活性和集成度上显著优于CCD。图像传感器尺寸是影响感光元件成像效果的关键因素,即传感器尺寸越大,感光面积越大,成像效果越好。

尽管CCD在灵敏度、分辨率和噪音控制等方面表现均好于CIS,但随着CMOS工艺发展以及手机像素升级,CIS 低功耗、高集成度的特性使得其能够在实现高像素、大感光面积的同时有效控制成本,因而成为高像素时代手机图像传感器的首选方案,因此也称作CMOS摄像头模组(CMOS Camera Modules,CCM)。
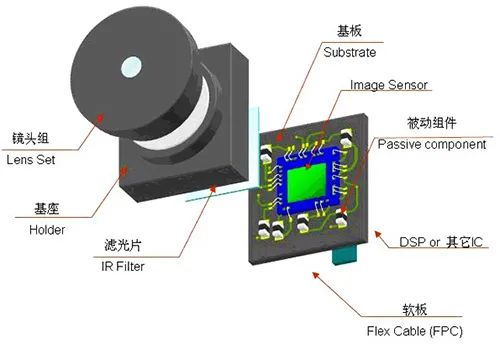
摄像头模组主要由软板排线(FBC),摄像传感器/感光器件(Image Sensor/CMOS),红外滤光片(IR Filter),基座(Holder),镜头组(Lens Set),基板(Substrate),音圈马达(VCM),印刷电路板(PCB)等组成,其主要部件的主要功能分别为:
镜头(Lens)
镜头相当于摄像头模组的眼睛,外部的光线通过镜头调整后进入摄像头模组内部。
图像传感器芯片,简称CIS(Camera Image Senor)
摄像头模组的核心部件,光线通过镜头进入摄像头模组后,在CIS上成像,CIS将光信号转变为电信号。
音圈马达,简称VCM(Voice Coil Motor)
VCM的主要功能是为了实现摄像头模组的自动对焦(Auto-focus)功能,通过改变VCM的驱动电流,通过VCM可以调整镜头的位置,从而实现对焦功能。
红外滤光片(IR Cut filter)
IR Cut filter滤除掉红外光,保证达到CIS的光线为可见光。
图像信号处理器,DSP(Digital Signal Processor)
CIS输出的图像信号,经过DSP初步处理后,传输给手机的处理器,完成屏幕上的成像。
目前主流的封装技术分为三种,一种为传统芯片级封装生产工艺流程CSP技术(chip size package),具体又分为FF模组生产工艺流程(适用于8W-300W像素)与AF模组生产工艺流程(适用于500W像素含以上),另外的为COB技术(chip on board),以及FC(flip chip)技术。
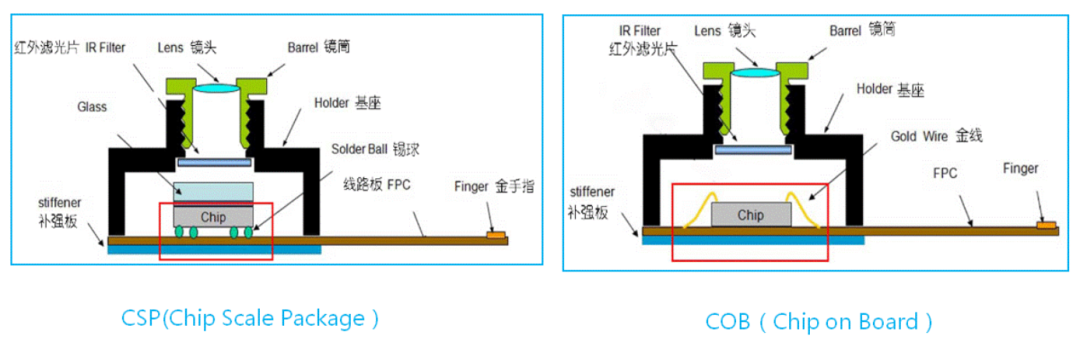
CSP技术的特点是,制造设备成本低廉,但是封装成本较高,主要的缺点是封装出来的手机摄像头模组厚度较高,镜头透光率一般,容易出现鬼影。
COB技术的特点是,制造设备成本造价较高,一条产线的造价大概为1000万人民币左右,但是封装成本较低,由于COB封装必须在无尘的环境下进行,因此良品变动率较大,制程时间相对更长。
FC技术的特点是,制造设备成本最高,一条FC制程的生产线成本是COB制程的生产线成本的1.3倍到5倍左右,也就是1300万到1500万的造价,但是其最大的优势在于封装出来的摄像头模组厚度最薄,可以说是摄像头模组封装领域最新潮的下一代封装技术。
以AF模组为例,CMOS摄像头模组的生产工艺流程简单概括为如下步骤:原物料清洗、Die Bond、Wire Bond、old Mount、Lens/VCM组立、Lens/VCM Mount、后段测试。

摄像头模组结构非常精细,内部多处元件有点胶工艺要求,主要用到的胶水主要有:UV胶,底部填充胶,低温固化胶等等。
1、LENS摄像头调整焦距后,需要用UV胶进行固定;
2、摄像传感器(Sensor)需要underfll底部填充工艺;
3、IR滤光片与Holder基座固定,需要涂一条宽度在0.2~0.3mm的胶固定,推荐采用高强度UV胶。
4、音圈马达VCM中的磁铁、弹片、垫片和YOKE等,推荐采用低温固化胶进行固定。
5、FPC补强,推荐使用UV胶。
热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

