热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

焊点的质量对决定SMT部件的可靠性和性能非常重要,BGA焊点的质量应该是关键。因此,采取有效措施确保BGA部件的焊点质量,实现SMT部件的最终可靠性非常重要。
虽然BGA技术在某些方面有所突破,但并非是十全十美的。由于 BGA封装技术是一种新型封装技术,与QFP技术相比 ,有许多 新技术指标需要得到控制。另外,它焊装后焊点隐藏在封装之下,不可能100%目测检测表面安装的焊接质量,为BGA安装质量控制 提出了难题。下面就为BGA检测做一个简单的介绍!
BGA焊前检测与质量控制
生产中的质量控制非常重要,尤其是在BGA封装中,任何缺陷都会导致BGA封装元器件在印制电路板焊装过程出现差错,会在 以后的工艺中引发质量问题。
封装工艺中所要求的主要性能有:封装组件的可靠性;与PCB的热匹配性;焊料球的共面性;是否能通过封装体边缘对准性,以及加工的经济性等。需指出的是,BGA基板上的焊球无论是通过高温焊球 (90Pb/10Sn)转换,还是采用球射工艺形成,焊球都有可能掉下丢失,或者形成过大、过小,或者发生焊料桥接、缺损等情况。 因此,在对BGA进行表面贴装之前,需对其中的一些指标进行检测控制。

BGA焊后质量检测
使用球栅阵列封装(BGA)器给质量检测和控制部门带来难题:如何检测焊后安装质量。由于这类器件焊装后,检测人员不可 能见到封装材料下面的部分,从而使用目检焊接质量成为空谈。其它如板截芯片(OOB)及倒装芯片安装等新技术也面临着同样的问 题。而且与BGA器件类似,QFP器件的RF屏蔽也挡住了视线,使目检者看不见全部焊点。为满足用户对可靠性的要求,必须解决不可 见焊点的检测问题。光学与激光系统的检测能力与目检相似,因为它们同样需要视线来检测。即使使用QFP自动检测系统AOI (Automated Optical Inspection)也不能判定焊接质量,原因是无法看到焊接点。为解决这些问题,必须寻求其它检测办法。 目前的生产检测技术有电测试、边界扫描及X射线检测。
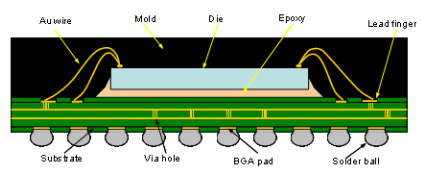
机械手视觉定位、图像处理库等为核心的20多款自主知识产权产品。涉及自动贴合机、丝印机、曝光机、叠片机、贴片机、智能检测、智能镭射等众多行业领域。双翌视觉系统最高生产精度可达um级别,图像处理精准、速度快,将智能自动化制造行业的生产水平提升到一个更高的层次,改进了以往落后的生产流程,得到广大用户的认可与肯定。随着智能自动化生产的普及与发展,双翌将为广大生产行业带来更全面、更精细、更智能化的技术及服务。
热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

