热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A
90年代前半期美国提出了第二代表面组装技术的IC封装技术--BGA(球栅阵列封装),其进一步的小型封装为CSP(芯片规模封装),在20世纪90年代末成为人们关注的焦点。
球栅阵列封装(BGA)
典型的球栅阵列封装(BGA)是非常耐用的,一旦被掉落到地板上之后,BGA可进行组装。这对PQFP封装来说,在某种程度上是不可能的。BGA的先进性为面积阵列形式,通常情况下较QFP在每一面积中提供较多的I/O数(如图2所示)。当I/O数大于250时,BGA所占用的空间总是小于QFP,由于BGA的引线间距通常较类似的QFP宽松,组装工艺较易,从而产生较高的效率。如果在组装前测定与封装相关的缺陷,那么此面积阵列封装第一次通过的组装效率可接近于小于1ppm/线水平。目前,BGA组装最大的问题是与封装相关的缺陷问题,这些问题可能起因于焊球丢失、湿敏性、装运破坏及回流焊期间过度的翘曲。球尺寸方面存在非常大的变化,是大约从球到球的容积差异的2至3倍。一个焊点位置上双层焊球及与金属化相关的缺陷,诸如球和元件焊盘之间的贫焊。由于工艺问题,BGA组装的最坚固的制造工艺提供最低的缺陷。然而,目前的组装问题仍困扰着面积阵列封装制造业。这不足为怪,由于BGA封装正常的成熟周期还未完成。
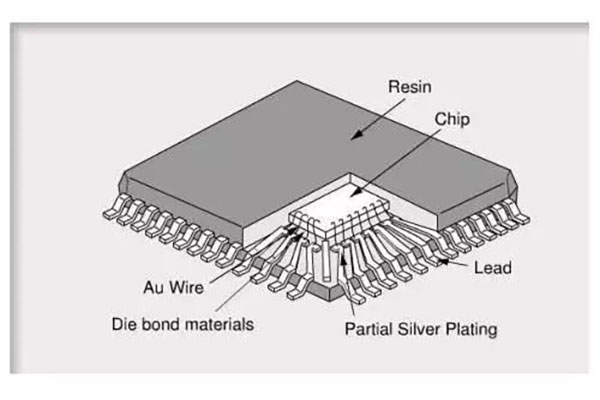
BGA封装的构造为在通常情况下,具有比等效的QFP较短的引线长度,因此具有较好的电性能。不过BGA构造引起的最大缺陷之一为成本问题,BGA较QFP昂贵的主要原因是与元件载体基板有关的叠层板和树脂的成本。BT树脂、陶瓷和聚酰亚胺树脂载体比QFPs包含有更昂贵的原始配料,而QFPs包含有低成本的模塑树脂和金属薄片引线框架。面积阵列载体的生产成本非常昂贵,是由于细线电路和化学处理工艺的缘故。另外,QFPs能够使用的封装硅材料与BGA封装工艺相比,其工艺步骤所要求的高输出精整压模和多腔模压较少。一旦形成高容积,面积阵列封装的成本将下降,但也许不会下降到QFP的成本状况。
就BGA封装的成本而言,有发展前景的例外情况就是适中的I/O数,即单层腔体向下型BGA封装。在此类型的阵列中,封装载体的焊球边缘上,所有的电路无须通孔。因此,对每个BGA封装而言,成本较高。BGA封装极具优势的组装效率将局部地弥补了这一差异。然而,当QFP适用时,在经济价值方面认为BGA只有在下列条件下将是合理的。低于200I/Os时,QFPs是适用的,相对来说易于组装。但高于200I/Os时,情况正好是相反的。而当QFP不适用时,这种状况将促使BGA广泛的使用。并且极具可能的情况是高引线元件,使用高于200I/Os的BGA封装。
BGA封装的检查与返修
BGA的检查和返修也是日趋成熟的技术。虽然可进行成品的检查,但是要求精密的设备诸如X射线成像系统或超声显微镜系统。随着整个BGA封装生产周期和经验的不断成熟,通过统计抽样检查所发现的问题会越来越少,从而使生产效率逐步提高。
返修也是一个值得考虑的问题,BGA的返修主要是由于与元件相关的各种缺陷,因此同完成良好的制造工艺关系重大。因为连接头位于封装体的下面,返修比周边上有引线器件的明接头困难得多。BGA返修方面的一些关键性的问题为:对拆卸部件的损坏,对替换部件的损坏,板与相邻元件过热,因局部加热出现板的翘曲,适当部位的清洗和制备。返修需要考虑的问题包括:芯片温度,返修周期内元件上的温度分布及板的温度分布。如果所有需要的装置都要购买的话,BGA返修台的费用将是非常昂贵的。
清洗
BGA封装的不利因素就是不能恰当地把位于阵列封装底部的板表面的焊剂废料洗掉。目前,高管脚数的面阵列封装在尺寸大小方面接近于45mm ,因此,清洗问题变得相当关键。清洗要求使用的各种焊剂和焊膏可导致电失效,并且在高功率应用中接地的性号会发生泄漏。为了减少残存于封装体底部未清除的焊剂废料而导致的问题,要求在大面积阵列封装应用中,使用免清洗焊剂/焊膏。采用各种溶剂的清洗系统可适当地清洗BGA封装体的底部,但是将面临各种环境限制和过高的成本问题。
BGA的各种规格
目前适用的几种规格的BGA封装类型包括:塑料过模BGA(PBGA),有机带式载体BGA(TBGA),陶瓷BGA(CBGA),陶瓷柱状阵列(CGA),腔体型BGA,包括热增强及芯片腔体朝下型,金属体BGA(MBGA)。一般认为,TBGA、CGA、CBGA封装使用高熔融焊料合金(10Sn/90Pb),而大部分别的BGAs使用低熔融共晶焊料63Sn/37Pb或接近于低共熔的62Sn/36Pb/2Ag焊料合金。
有效性(利用率)
概括地说,在过去几年中已通用的高于208个管脚、间距为0.5mm款式的QFPs ,应用范围不够广泛,更高管脚数的QFPs包括256个管脚、间距0.4mm,304个管脚、间距0.4mm的各个品种,应用范围也不够广泛。大部分QFPs为塑料和陶瓷壳体款式,通常各类塑料型器件适合于较高的引线数。另外,两种较少使用的QFP类型为密封TAB型和金属壳体型(高热损耗)。随着QFP封装引线数的增加,其壳体尺寸急剧地增加,可以替代封装尺寸增加的是更进一步缩减引线间距。一些商用的0.3mm间距的器件已获得成功,但是有限的封装有效性和非常密的组装工艺已防碍着大规模的器件组装。
BGAs在高于200I/O数水平的各种各样的类型中是通用的,在塑料BGAs中,通用的封装规格包括225、256、313、352、361和400I/O数的各种元件。各种热增强型面阵列封装包括479和503个管脚的类型。腔体向下型BGAs目前适用的为204、208、240、256、312、352、432、479、560和596等各种款式。提供的TBGAs的类型的管脚数分别为:240、342、432、647和736,并且可安装散热片或在封装的后背部粘附一个金属板。CBGAs典型地使用于非常高的管脚数的各种应用,并且一般为高于1000I/O数。为了获得高的热损耗问题的解决,近年来已开展进行两种金属壳体型BGAs的尝试。
发展趋势
可预见,未来一段时间里,引线数低于200的PQFP将成为主要的封装技术。当引线数高于350时,QFPs要得到广泛的应用是不可能的。在200到300I/O的各类器件之间,将继续存在两个封装技术领域之间的竞争。因此,小于0.5mm的QFP封装工艺将被极具吸引力的BGAs封装工艺所代替。然而,与PQFPs较适中的8%的年增长率相比较,BGA的年增长率将增大为每年25%。
深圳市双翌光电科技有限公司是一家以机器视觉为技术核心,自主技术研究与应用拓展为导向的高科技企业。公司自成立以来不断创新,在智能自动化领域研发出视觉对位系统、机械手视觉定位、视觉检测、图像处理库等为核心的20多款自主知识产权产品。涉及自动贴合机、丝印机、曝光机、叠片机、贴片机、智能检测、智能镭射等众多行业领域。双翌视觉系统最高生产精度可达um级别,图像处理精准、速度快,将智能自动化制造行业的生产水平提升到一个更高的层次,改进了以往落后的生产流程,得到广大用户的认可与肯定。随着智能自动化生产的普及与发展,双翌将为广大生产行业带来更全面、更精细、更智能化的技术及服务。