热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

传统集成电路(IC)封装的主要生产过程
IC的封装工艺流程可分为晶元切割、晶元粘贴、金线键合、塑封、激光打印、切筋打弯、检验检测等步骤。
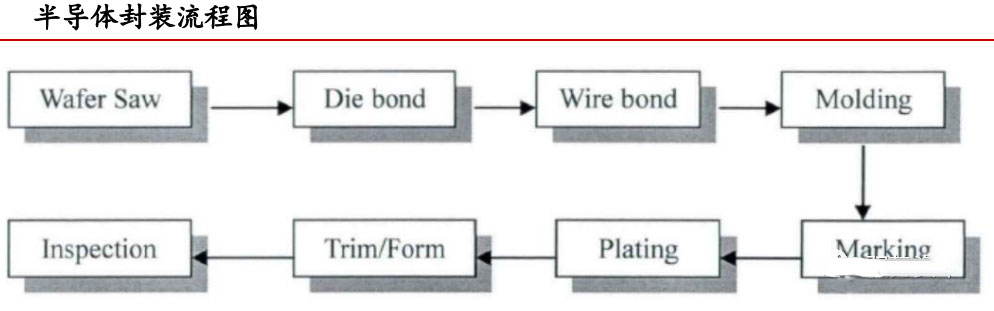
传统半导体封装的七道工序

晶圆切割
首先将晶片用薄膜固定在支架环上,这是为了确保晶片在切割时被固定住,然后把晶元根据已有的单元格式被切割成一个一个很微小的颗粒,切割时需要用去离子水冷却切割所产生的温度,而本身是防静电的。
晶圆粘贴
晶圆粘贴的目的将切割好的晶元颗粒用银膏粘贴在引线框架的晶元庙上,用粘合剂将已切下来的芯片贴装到引线框架的中间燥盘上。通常是环氧(或聚酰亚胺)用作为填充物以增加粘合剂的导热性。
金线键合
金线键合的目的是将晶元上的键合压点用及细的金线连接到引线框架上的内引脚上,使得晶圆的电路连接到引脚。通常使用的金线的一端烧成小球,再将小球键合在第一焊点。然后按照设置好的程序拉金线,将金线键合在第二焊点上。
塑封
将完成引线键合的芯片与引线框架置于模腔中,再注入塑封化合物环氧树脂用于包裹住晶元和引线框架上的金线。这是为了保护晶元元件和金线。塑封的过程分为加热注塑,成型二个阶段。塑封的目的主要是:保护元件不受损坏;防止气体氧化内部芯片;保证产品使用安全和稳定。
激光打印
激光打印是用激光射线的方式在塑封胶表面打印标识和数码。包括制造商的信息,器件代码,封装日期,可以作为识别和可追溯性。
切筋打弯
将原来连接在一起的引线框架外管脚切断分离,并将其弯曲成设计的形状,但不能破坏环氧树脂密封状态,并避免引脚扭曲变形,将切割好的产品装入料管或托盘便于转运。
检验
检验检查产品的外观是否能符合设计和标准。常见的的测试项目包括:打印字符是否清晰、正确,引脚平整性、共面行,引脚间的脚距,塑封体是否损伤、电性能及其它功能测试等。
热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

