热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

陶瓷基板由于其良好的导热性、耐热性、绝缘性、低热膨胀系数和成本的不断降低,在电子封装特别是功率电子器件如IGBT(绝缘栅双极晶体管)、LD(激光二极管)、大功率LED(发光二极管)、CPV(聚焦型光伏)封装中的应用越来越广泛。
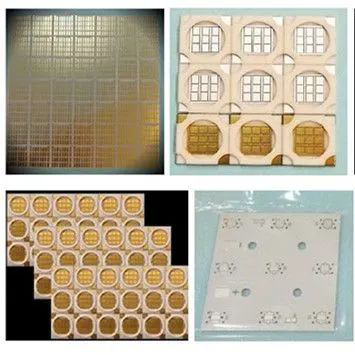
陶瓷基片主要包括氧化铍(BeO)、氧化铝(Al2O3)和氮化铝(AlN)、氮化硅(Si3N4)。与其他陶瓷材料相比,Si3N4陶瓷基片具有很高的电绝缘性能和化学稳定性,热稳定性好,机械强度大,可用于制造高集成度大规模集成电路板。

几种陶瓷基片材料性能比较
从结构与制造工艺而言,陶瓷基板又可分为HTCC、LTCC、TFC、DBC、DPC等。
陶瓷基板的特点
陶瓷基板,是以电子陶瓷为基础,对电路元件及外贴切元件形成一个支撑底座的片状材料。陶瓷基片具有耐高温、电绝缘性能高、介电常数和介质损耗低、热导率大、化学稳定性好、与元件的热膨胀系数相近等主要优点。
陶瓷基板的种类
A: 96/99氧化铝陶瓷基片:应用范围最广。
B:氮化铝陶瓷基片:导热系数高,无毒,可代替BeO陶瓷基片。
C:氮化硅陶瓷基片:强度高,虽导热系数比不上氮化铝陶瓷,但可以通过减小厚度来减小热阻。
D: BeO陶瓷基片:迄今为止最好的绝缘性陶瓷,但加工时产生的粉末会对人体产生毒害作用。
E:滑石瓷:高频性能好,成本低。
F:铁氧体陶瓷片:可以减小电路体积,用于制作射频微带线及滤波电路。
G:超大规格陶瓷片
H:抛光类陶瓷基片,可进行单、双面抛光加工,表面光洁度经抛光处理后达到Ra:0.03-0.05μm,无孔洞现象,产品适合体积小、精度高、布线密度高。
高温共烧多层陶瓷基板(HTCC)
HTCC,又称高温共烧多层陶瓷基板。制备过程中先将陶瓷粉(Al2O3或AlN)加入有机黏结剂,混合均匀后成为膏状浆料,接着利用刮刀将浆料刮成片状,再通过干燥工艺使片状浆料形成生坯;然后依据各层的设计钻导通孔,采用丝网印刷金属浆料进行布线和填孔,最后将各生坯层叠加,置于高温炉(1600℃)中烧结而成。此制备过程因为烧结温度较高,导致金属导体材料的选择受限(主要为熔点较高但导电性较差的钨、钼、锰等金属),制作成本高,热导率一般在20~200W/(m·℃)。
低温共烧陶瓷基板(LTCC)
LTCC,又称低温共烧陶瓷基板,其制备工艺与HTCC类似,只是在Al2O3粉中混入质量分数30%~50%的低熔点玻璃料,使烧结温度降低至850~900℃,因此可以采用导电率较好的金、银作为电极材料和布线材料。因为LTCC采用丝网印刷技术制作金属线路,有可能因张网问题造成对位误差;而且多层陶瓷叠压烧结时还存在收缩比例差异问题,影响成品率。为了提高LTCC导热性能,可在贴片区增加导热孔或导电孔,但成本增加。
厚膜陶瓷基板(TFC)
相对于LTCC和HTCC,TFC为一种后烧陶瓷基板。采用丝网印刷技术将金属浆料涂覆在陶瓷基片表面,经过干燥、高温烧结(700~800℃)后制备。金属浆料一般由金属粉末、有机树脂和玻璃等组分。经高温烧结,树脂粘合剂被燃烧掉,剩下的几乎都是纯金属,由于玻璃质粘合作用在陶瓷基板表面。烧结后的金属层厚度为10~20μm,最小线宽为0.3mm。由于技术成熟,工艺简单,成本较低,TFC在对图形精度要求不高的电子封装中得到一定应用。
直接键合铜陶瓷基板(DBC)
由陶瓷基片与铜箔在高温下(1065℃)共晶烧结而成,最后根据布线要求,以刻蚀方式形成线路。由于铜箔具有良好的导电、导热能力,而氧化铝能有效控制 Cu-Al2O3-Cu复合体的膨胀,使DBC基板具有近似氧化铝的热膨胀系数。
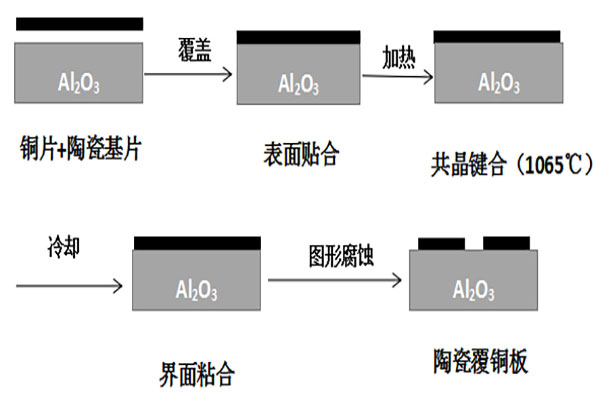
DBC基板制备工艺流程
DBC具有导热性好、绝缘性强、可靠性高等优点,已广泛应用于IGBT、LD和CPV 封装。DBC缺点在于,其利用了高温下Cu与Al2O3间的共晶反应,对设备和工艺控制要求较高,基板成本较高;由于Al2O3与Cu层间容易产生微气孔,降低了产品抗热冲击性;由于铜箔在高温下容易翘曲变形,因此DBC表面铜箔厚度一般大于100m;同时由于采用化学腐蚀工艺,DBC基板图形的最小线宽一般大于100m。
直接镀铜陶瓷基板(DPC)
其制作首先将陶瓷基片进行前处理清洗,利用真空溅射方式在基片表面沉积Ti/Cu层作为种子层,接着以光刻、显影、刻蚀工艺完成线路制作,最后再以电镀/化学镀方式增加线路厚度,待光刻胶去除后完成基板制作。
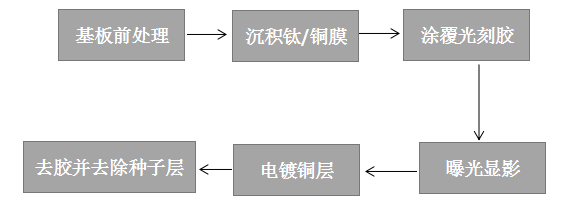
DPC基板制备工艺流程
DPC技术具有如下优点:低温工艺(300℃以下),完全避免了高温对材料或线路结构的不利影响,也降低了制造工艺成本;采用薄膜与光刻显影技术,使基板上的金属线路更加精细,因此DPC基板非常适合对准精度要求较高的电子器件封装。但DPC基板也存在一些不足:电镀沉积铜层厚度有,且电镀废液污染大;金属层与陶瓷间的结合强度较低,产品应用时可靠性较低。
热线电话:0755-23712116
邮箱:contact@shuangyi-tech.com
地址:深圳市宝安区沙井街道后亭茅洲山工业园工业大厦全至科技创新园科创大厦2层2A

