多层电路图案套刻:这是最核心的应用。在制造复杂的集成电路时,需要将数十层电路图案精确地叠加在一起,对准软件确保每一层都与前一层完美对齐,其精度直接决定了芯片的良率和性能。
晶圆步进重复曝光:在光刻工序中,软件控制光刻机将掩模版上的图形一次次精确地“印刷”到晶圆的不同区域。
2.5D/3D 封装:在芯片堆叠、晶圆级封装等先进封装技术中,需要对晶圆与晶圆、或芯片与晶圆进行超高精度的对准和键合。
异质集成:将不同工艺、不同材料的芯片(如逻辑芯片与存储芯片)集成在一起,对准软件是实现这一复杂过程的关键。
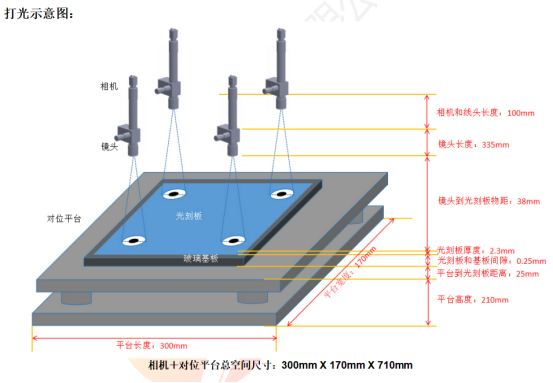
多层电路图案套刻:这是最核心的应用。在制造复杂的集成电路时,需要将数十层电路图案精确地叠加在一起,对准软件确保每一层都与前一层完美对齐,其精度直接决定了芯片的良率和性能。
晶圆步进重复曝光:在光刻工序中,软件控制光刻机将掩模版上的图形一次次精确地“印刷”到晶圆的不同区域。
2.5D/3D 封装:在芯片堆叠、晶圆级封装等先进封装技术中,需要对晶圆与晶圆、或芯片与晶圆进行超高精度的对准和键合。
异质集成:将不同工艺、不同材料的芯片(如逻辑芯片与存储芯片)集成在一起,对准软件是实现这一复杂过程的关键。
智能化:算法与机器视觉的深度融合,能从晶圆表面复杂的图案中快速识别出关键对准标记,即使在存在工艺偏差的情况下,也能精准定位标记的亚像素级位置。
先进算法:采用亚像素定位、高斯拟合、相位匹配等复杂算法,将图像识别精度提升至0.5微米级别。例如,通过计算标记中心的坐标,可将误差控制在0.5微米以内。
机器视觉:集成高分辨率CCD摄像机和先进的图像处理单元,实现非接触式、实时动态校准。不仅能检测对准标记,还能识别晶圆缺陷,通过“机器视觉+计算机视觉”的组合,在保持生产速度的同时,智能区分真实缺陷与无害变异,减少误报。
实时反馈与控制:现代系统集成了原位计量和实时反馈回路,能够持续监测对准精度,并通过前馈控制算法预测并补偿运动过程中的振动与延迟,实现主动纠错。